2차시_반도체 공통요소 기술-진공, 플라즈마
- 진공이란 무엇인가?
진공은 사전적 정의는 "물질이 전혀 존재하지 않는 공간" 입니다. 즉, 아무것도 없는 공간을 의미합니다. 우주는 진공이며, 중력이 없으니 공기도 없고 물질도 없습니다.
토리첼리의 실험을 통해 진공을 원리를 알 수 있습니다. 한쪽이 막힌 1m 길이의 유리관에 수은을 가득 넣고 막히지 않는 쪽을 수은 가득 곳에 수직으로 세우면 1m 길이의 유리관에서 760mm의 높이까지 내려오고 멈추게 됩니다. 이것은 대기압에 의한 것이며, 관의 위쪽에는 진공이 생깁니다. 또한 이것을 우리는 대기압의 압력으로 표현하고 표기하게된 계기가 된 것입니다. [ 760mmHg (밀리미터머큐리) ]
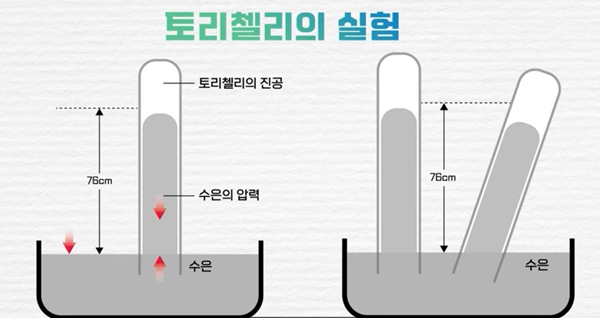
< 압력을 표기법 >

다시 본론으로 돌아와서, 일상생활에서 진공을 경험할 수 있는게 무엇이 있을까? 바로 진공청소기입니다. 청소기 속에 있는 모터를 1분에 10000회 이상 돌림으로써 내부압력 대비 외부 압력을 진공에 가깝게 낮춤으로써 외부의 높은 압력차로 먼지를 속으로 빨아 들이는 것입니다. 다른 예시는 보온병이 있습니다. 보온병이 온도를 유지시킬 수 있는 이유는 바로 진공입니다. 보온병의 벽에 얇게 진공막이 있어서 외부와의 온도를 차단하여 내부의 온도를 오랜 시간 유지할 수 있는 것입니다.
- 반도체에서 진공이 필요한 이유

이제 반도체 제조에서 진공이 필요한 이유에 대해 살펴보겠습니다. 앞에서 예를 들었던 진공청소기와 보온병의 원리가 반도체 공정에서도 적용됩니다. 챔버 속에서 반도체를 생산하기 위해 진공환경을 만드는 과정과 유지하는 과정에서 불필요한 이물질들은 펌프를 통해 바깥으로 빨려 나가게 됩니다. 또한 일부 이물질이 남아있게 되더라도 진공상태에서는 이물질이 활발하게 움직일 수 없기 때문에 공정에 영향을 거의 줄 수 없게 됩니다. 그리고 진공상태에서 챔버 내부를 공정 진행에 필요한 특정 온도로 세팅한 경우, 열전달의 역할을 하는 기체가 굉장히 적은 상태이기 때문에 온도가 변하지 않도록 유지할 수 있게 됩니다. 만약 반도체 공정에서 진공이 없다면?



이물질 컨트롤이 불가하여 박막을 증착하는 과정에서 원치않는 증착이 이루어 질 수 있고 또한 식각 공정에서 플라즈마를 컨트롤 하지 못하게 되어 원하는 곳에 식각을 하지 못하게 됩니다. 또한 반도체 제조는 특정 환경(특정온도)에서 진행되어야 하는데 챔버 내 이물질 분자들의 움직이 활발해지면 그로 인해 온도가 예상보다 더 높아져서 챔버가 버틸 수 있는 한계를 넘어서게 되면 터질 수 도 있습니다. 따라서 결국, 반도체 생산을 진공 상태에서 진행하지 않으면 품질 문제가 발생 할 수 밖에 없습니다.
- 진공상태 만들기
반도체 공정에서 진공상태를 만드는 방법은 진공청소기의 원리와 동일합니다 모터의 팬을 빠르게 회전시켜서 압력을 낮추는 것입니다. 우리는 이것을 펌프라고 부릅니다. 펌프는 저진공의 영역을 만드는 펌프와 고진공의 영역을 만드는 펌프로 나뉘어 있습니다. 그래서 저진공을 만드는 펌프가 먼저 작동한 후 고진공을 만드는 펌프가 작동하여 다양한 영역대의 진공을 만들어 내게 되는 것입니다.

그렇다면 펌프를 이렇게 영역대별로 나눠놓은 이유는 무엇일까요? 바로 펌프의 구조와 효율성 때문입니다. 대기압부터 저진공, 중진공, 고진공의 영역을 모두 만들 수 있는 펌프를 만들었다고 가정했을 때, 반도체는 24시간 동안 생산하는 만큼 챔버 속의 가혹한 조건을 견디지 못하고 부품이 고장나거나 깨지는 경우가 많습니다. 이 때 챔버를 열고 부품을 교체하려면 챔버 내부도 대기압의 상태가 되어야 합니다. 그러나 대기압을 만들려면 압력을 서서히 올려서 펌프의 팬에 무리가 가지 않도록 해야합니다. 압력을 빠르게 올릴 경우 고속으로 돌고 있는 팬에 큰 충격이 가해지고 이를 견디지 못하고 팬이 부러지게 됩니다. 고진공의 영역부터 대기압까지는 영역이 넓은 만큼 천천히 압력을 올릴 경우 시간이 아주 오래 걸리게 될 것 입니다. 그래서 이러한 점을 보완하기 위해 저진공용 펌프와 고진공용 펌프를 나누게 된 것 입니다. 이렇게 저진공과 고진공 펌프가 나뉘어진다면 저진공 이후에 고진공 펌프로 바꿔줘야하는건가 ?

이런 점을 방지하기 위해 반도체 장비에서는 밸브라는 것을 사용하고 있습니다. 우선 저진공용 펌프와 고진공용 펌프는 가동이 된 상태로 항상 유지합니다. 이후 챔버를 진공상태에서 대기압으로 바꿔야할 때 펌프와 챔버 사이에 밸브를 설치하여 밸브를 잠가 독립적인 공간을 만들도록 합니다.


이후 챔버 내부에 N2처럼 반응성이 낮은 기체를 넣어주면서 압력을 서서히 올리도록 합니다. 그러면 펌프가 가동이 멈출 때까지 기다리는 시간보다 더 빠르게 진공을 대기상태로 바꿀 수 있습니다. 반대로 대기를 진공 상태로 만들어야 하는 경우 챔버와 저진공용 펌프 사이에 밸브를 열어주면 됩니다. 그러면 빠른 시간 내에 대기영역에서 저진공 영역으로 바뀌게 됩니다. 이후 저진공용 펌프로 연결되는 밸브를 잠그고 고진공용 펌프로 연결되는 밸브를 열어주어 빠르게 챔버 내부를 고진공으로 만들어줍니다. 이렇게 되면 펌프의 내구성에 무리가 가지 않으면서 빠른 시간만에 고진공에서 대기까지 자유자재로 변화할 수 있습니다. 현재 이 방법을 사용해서 공정을 진행하고 있고 부득이하게 펌프에 이물질이 들어가서 파손이 되는 경우 챔버와 펌프 사이의 관을 점검해야 하는 경우 등을 제외하면 펌프 가동을 중단하는 경우는 없습니다. 이렇게 진공을 만드는 법에 대해서 알아보았습니다.
- 진공이론
평균 자유 이동 거리 (Mean Free Path, MFP)는 기체 분자가 다른 기체 분자와 충돌 후 또 다른 기체 분자와 충돌할 때 까지의 거리를 뜻합니다. 압력이 높아지면 기체 분의 움직임이 활발해져 다른 기체 분자와 충돌 후 또 다른 기체 분자와 바로 충돌하게 될 것 입니다. 여기서 압력의 정읜는 공기분자들이 운동을 하며 용기벽에 충돌하여 용기벽에 작용하는 단위면적당 힘입니다. 온도가 올라가면 압력이 올가는 이유도 이러한 이유입니다.
- 플라즈마란 무엇인가?

플라즈마는 기체상태에서 열을 가해 양이온과 전자로 분리되어 이루어진 영역을 의미합니다. 고체, 애게, 기체 다음의 영역이라 제 4의 물질 상태라고 취급합니다. 우리 생활에서 쉽게 찾아볼 수 있는 플라즈마 예시로는 번개입니다. 번개가 번쩍하는 과정이 바로 플라즈마 영역이 발생하는 과정입니다.
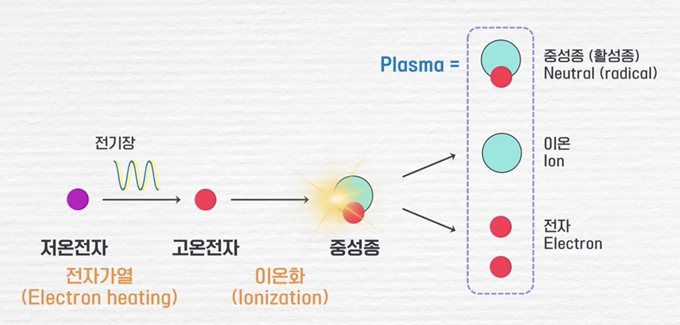
기체에 고온의 에너지가 가해져 양이온과 전자로 나뉘는데 양이온과 전자가 큰 에너지를 갖고 분리되어 서로 불안정한 상태인 만큼 원래의 상태로 되돌아가려는 성질이 있습니다. 이 때 원래의 안정된 상태로 돌아가면서 갖고 있던 큰 에너지를 빛 에너지로 방출하게 되는데 이것이 우리가 흔히 보는 번개의 모습입니다. 번개가 발생하는 현상을 원리를 통해 더 구체적으로 설명하도록 하겠습니다.
- 플라즈마 생성 설명을 위한 간단한 이론 설명

기본적으로 원자는 양성자, 중성자, 전자로 이루어져 있습니다. 전자란 음전하를 가진 기본 입자로서 원자의 구성성분이기도 합니다. 1897년 톰슨이 발견했습니다. 전자는 양성자와 중성자와 더불어 원자의 주요 구성성분이기도 합니다. 전자는 양성자에 비해 무게가 2000분의 1정도인 만큼 움직임이 자유롭습니다. 그래서 여러 차례 충돌을 통해 플라즈마 생성에 중요한 역할을 합니다.

양이온이란 중성의 원자가 전자를 잃고 양의 전하를 띠게 되는 것입니다. 원자는 기본적으로 양성자와 중성자, 전자가 같은 개수로 평행을 이루고 있는데 여기서 전자가 빠지게 되면 이것이 곧 양이온이 되는 것입니다. 양이온은 전자에 비해 무게가 무겁습니다. 그래서 플라즈마 공정 진행시 양이온을 이용하여 실리콘 위의 막질을 깎아내거나 반대로 막질을 쌓아 올리는 것이 가능합니다.

이온화(Ionization)란 중성의 원자에서 전자를 잃거나 얻는 전자 이동이 일어나 전하를 띠게 되는 반응입니다. 앞에서 언급한 것처럼 원자가 전자를 잃어서 양이온이 되는 과정이 이온화입니다.

여기와 발광(Excitation & Relaxation), 여기는 고온전자가 충돌하여 중성원자의 전자가 기존의 궤도에서 벗어나는 것이고 탈여기는 궤도에서 벗어났던 전자가 다시 원래의 궤도로 돌아오는 것을 의미합니다. 탈여기하는 과정에서 빛에너지가 나오게 되는데 이 과정은 위에서 언급했던 번개의 개념을 생각하면 됩니다.
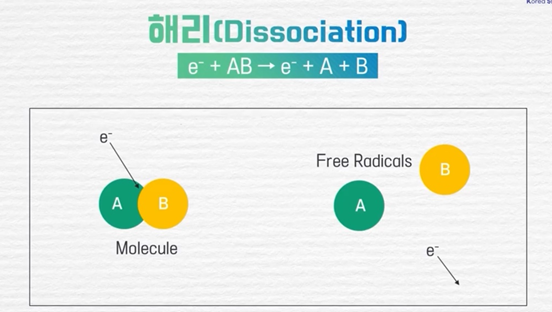
해리(Dissociation)란 고온전자가 분자와 충돌하여 분자의 화학 결합을 끊어서 Radical을 만드는 것입니다. 해리 반응을 통해 분리된 Radical들은 불안정한만큼 반응성이 매우 높습니다. 그래서 화학 반응이 잘 일어나고 이러한 특성을 이용해 CVD공정이나 Etch 공정에서 많이 활용되고 있습니다.
- 플라즈마 생성원리
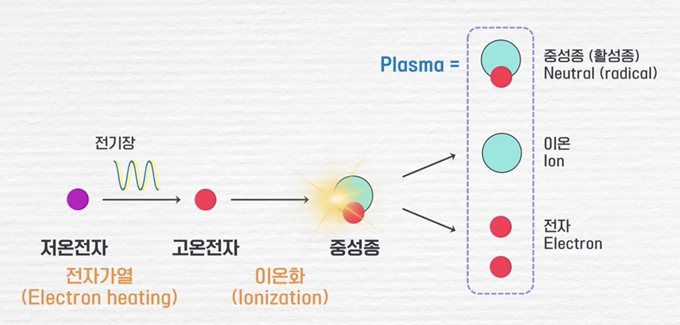
모든 기체 분자는 양이온과 전자가 결합된 안정된 상태로 존재합니다. 이 상태에서 챔버에 반응 가스를 주입하고 전기장을 인가 하면 저온이었던 전자가 가속하여 고온 전자가 됩니다. 이 고온 전자는 기존에 있던 중성가스와 충돌하여 이온화 반응이 일어납니다. 이렇게 생성된 전자는 다른 원자와 충돌해 이온화 반응이 일어나고 이 과정이 반복되면서 플라즈마 영역이 생성되는 것 입니다. 그리고 공정에 사용하는 가스를 주입 할 경우 해리가 일어나면서 반응성이 큰 Radical을 만들게 됩니다.
- 플라즈마 종류
DC 플라즈마와 RF 플라즈마로 나뉘게 됩니다.


DC 플라즈마는 DC power 즉, 직류를 이용한 플라즈마로 한 쪽은 양극, 다른 쪽은 음극을 나타냅니다. 그래서 양극쪽으로 전자들이 활발하게 이동하고 음극쪽으로는 양이온이 이동하게 됩니다. 음극쪽에는 - 전압이 인가되므로 전자는 멀어지게 되고 양이온만 가득하게 되는데 이 때 음극 SHeath가 생성되게 됩니다. 음극쪽에 공정에 사용할 Taget 물질을 두면 양이온이 부딪히면서 Sputtering이 일어나는 것이고 웨이퍼를 두게 되면 양이온이 부딪히면서 Ethching이 일어나는 것입니다.반대로 양극쪽에는 전자가 가득하게 되면서 가벼운 전자는 빠르게 빠져나가게 됩니다. 이로 인해 음극과 같이 마찬가지로 어두운 영역이 SHeath가 형성되게 됩니다. DC플라즈마의 이러한 특성 때문에 부도체 사용이 제한됩니다. 전극이 한쪽 방향으로만 흐르기 때문에 부도체 표면에 음극의 경우 이온이 양극의 경우 전자가 축적되게 됩니다. 양이온이 축적된 음극은 일정 이상의 양이온이 더 이상 음극으로 다가오지 못하고 결국 표면에서 일정 부분은 전기적 평형상태가 깨짐으로써 플라즈마가 소멸되게 되는 것입니다. 양이온과 전자가 적절한 밸런스를 유지하며 여기와 탈여기를 반복하면서 플라즈마 영역이 유지가 되는 것인데 이처럼 양이온만 계속 증가하게 된다면 더 이상 플라즈마 영역이 유지되는 것이 어려워지기 때문입니다. 이것이 SHeath가 생기게 되는 이유입니다.
그래서 도체를 이용하여 공정을 해야 양이온과 전자가 음극과 양극에 축적되지 않게 되고 계속 공정을 진행할 수 있게 됩니다. 하지만 반도체는 도체와 부도체 특성을 둘 다 지니고 있습니다. 도체의 역할도 필요하지만 부도체의 역할도 필요한 만큼 부도체를 이용한 공정도 필연적으로 진행해야 합니다. 그래서 이러한 부분을 극복하기 위해 RF 플라즈마를 사용하게 된 것 입니다.
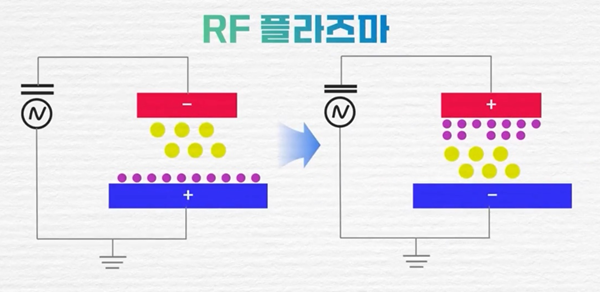
RF 플라즈마는 한 쪽 극에 교류를 흘려 수시로 +와 -가 바뀌게 되는 것입니다. 이것의 장점은 극의 성질이 수시로 +와 -로 바뀌게 됨으로써 극의 표면에 위치하던 양이온이 +일 때는 멀어지고 -일 때는 가까워지기 때문에 축적이 일어나지 않는 점입니다. 쉽게 말해 눈이 쌓일 때마다 눈을 밀어서 치워줌으로써 도로를 불편함없이 사용할 수 있게 해주는 것입니다. 이로 인해 부도체를 사용하여 공정을 진행할 수 있게 되었습니다. 하지만 이것의 단점은 결국 DC 파워를 번갈아 가면서 인가해 주는 것인 만큼 Sputtering 이나 Etching을 진행하기에 양이온의 충돌하는 힘이 약할 수 있습니다. 양이온은 전자에 비해 무거운 만큼 빠르게 음극에 달려와서 붙기 어렵기 때문입니다. 그래서 고안하게 된 아이템이 바로 양극과 음극의 크기를 변화하는 것입니다. Sputtering의 경우 Target 물질을, Etching의 경우 Wafer를 크기가 작은 극에 위치합니다. + 전하를 인가할 경우 상대적으로 가벼운 전자가 먼저 달려오게 됩니다. 하지만 기판의 면적이 작은 만큼 전자가 표면에 전부 붙지 못하고 위에 남게 되는데 이 상태에서 - 전하를 인가할 경우 반대편으로 다시 멀어지게 됩니다. 그리고 다시 + 전하를 인가하면 다시 전자가 몰리게 되는데 기판의 크기가 작은 만큼 이동이 비교적 자유로운 전자가 기판 위에 점차 모이게 됩니다. 교류를 인가하여 +와 -로 바뀌게 되지만 넓은 기판에서는 전자가 골고루 흡수되는 반면 기판의 크기 작은 곳은 전자가 점차 남게 되고 +를 인가하여도 특성이 - 인 형태가 되게 됩니다.

이것을 Self Bias 즉, 자기 바이어스라고 부르게 됩니다. 분명 + 전하를 인가하였지만 전자가 빠져나가지 못해 - 인 상태가 되는 시간이 길어져 음극의 특성을 가지게 되어 DC Self Bias가 되는 것입니다. 그래서 전압값이 - 로 점차적으로 내려가게 되는 것입니다. 이로 인해 양이온은 더 많은 양이 타겟으로 몰리게 되고 당기는 힘이 강해지는 만큼 Sputtering이나 Etching이 가능해지게 되었습니다. 그래서 부도체를 이용한 공정에서도 RF 플라즈마를 통해 다양한 공정을 진행할 수 있습니다.
- 플라즈마 생성 방식
이 RF 플라즈마를 이용한 방식에도 종류가 있습니다. 대표적인 방식이 CCP 방식과 ICP 방식입니다. 먼저 가장 보편화된 방식인 CCP 방식입니다.
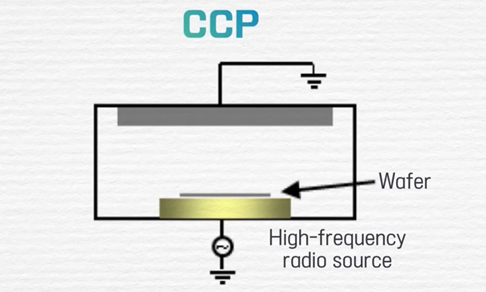

CCP방식은 Capacitively Coupled Plasma의 약자로 단단한 Oxide나 Nitride와 같은 유전체 박막을 Etch할 때 사용합니다. 보통 양극 중 자기 바이어스를 이용하기 위해 작은 면적의 기판 쪽에 Target을 올리고 이 부분에 RF 전압을 걸어주는 방식을 사용하고 있습니다. 반대쪽은 Ground 역할을 합니다. CCP 방식은 많은 식각 장비에서 사용하는 방식으로 한쪽에 Power를 걸어주는 방식이라 구조가 단순하다는 장점이 있습니다. 그리고 플라즈마 균일도가 높다는 장점이 있습니다. 그래서 웨이퍼 면적이 커져도 대응이 가능하다는 장점이 있습니다. 또한 하부 전극과 플라즈마 사이에 높은 전압으로 이온 에너지가 높아 결합이 강한 물질을 식각하거나 증착할 때 용이합니다. 반면에 플라즈마 밀도가 낮다는 단점이 있습니다. 단일 RF 파워로 이온 에너지와 전자 밀도를 동시에 제어하는 것이 불가능하기 때문입니다. RF Power를 증가시켜 Ion 밀도를 증가시켜서 식각율을 증가시키는 것이 가장 좋지만, RF Power가 증가함에 따라 Ion Energy가 증가해 기판에 Damage도 증가합니다. 그래서 RF Power를 낮추면 플라즈마가 분산되고 상쇄되는 부분이 많아져서 결과적으로 플라즈마 밀도가 낮아지게 됩니다. 또한, 미세공정으로 감에 따라 기술력의 한계가 다가오고 있습니다. 식각의 여러 공정 중 하나인 고종횡비 식각 공정은 회로가 미세해짐에 따라 구멍이 점점 좁아지고 깊게 뚫을 수록 끝 부분을 덜 식각하거나 사선으로 들어갈 경우 엉뚱한 부분을 식각하게 되는 경우가 생기게 됩니다.
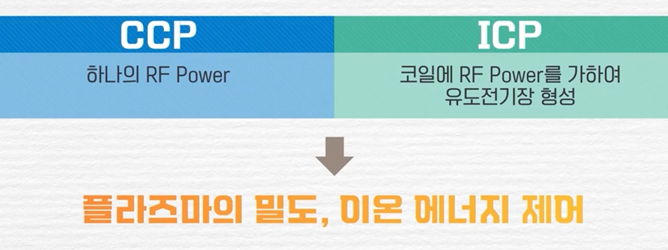
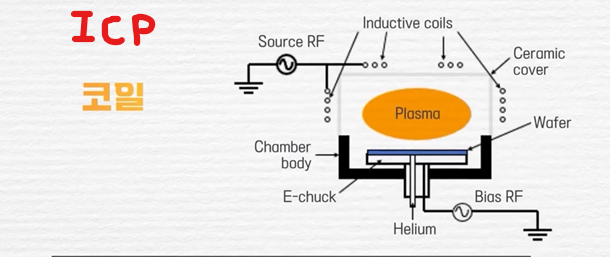
그래서 이러한 부분을 보완하기 위해 사용하는 방식이 ICP 방식입니다. ICP 방식은 Inductively Coupled Plasma의 약자로 CCP 방식과 다르게 코일을 사용해 플라즈마를 생성하는 방식입니다. CCP 방식은 하나의 RF Power로 플라즈마의 밀도와 이온에너지를 모두 컨트롤 해야했다면 ICP 방식은 코일에 RF Power를 가하여 유도전기장을 형성하는 방식입니다. 이를 통해 플라즈마의 밀도와 이온 에너지를 모두 컨트롤 할 수 있게 된 것입니다. 따라서 CCP 방식에 대해 ICP 방식이 플라즈마 밀도가 장점이 있습니다. CCP 방식은 고압에서 플라즈마 밀도를 높일 수 있었지만 ICP 방식은 저압에서도 플라즈마 밀도를 충분히 고밀도로 만들 수 있는 것입니다. 이로 인해 평균 자유 이동거리가 커져서 이온의 방향성이 좋아지고 좀 더 복잡한 구조의 Etch가 가능해집니다. 반면 역설적으로 단점이 코일에 있다는 점입니다. 플라즈마가 형성되는 영역이 코일에 영향을 많이 받는 만큼 코일의 크기가 곧 플라즈마의 영역입니다. 그러나 플라즈마 영역을 키우기 위해 무리하게 코일을 키울 경우 플라즈마 영역이 뒤틀리게 되어 오히려 효율 면에서 감소하는 효과가 발생합니다. 또한, 위치에 따라 플라즈마 균일도가 떨어지는 단점이 있습니다. 코일도 기본적으로 원모양의 회전하는 모양을 갖고 있지만 안테나의 구조에 따라서 플라즈마의 균일도도 천차만별로 바뀌게 됩니다. 플라즈마는 코일의 모양을 따라서 정해진 경로를 돌기에 중간과 가장자리 부분의 플라즈마 밀도가 낮아지게 됩니다. 그리고 CCP 방식보다 구조가 복잡합니다. 코일이 추가되는 만큼 고려해야할 변수가 더 늘어난 셈이기 때문입니다. 하지만 그럼에도 ICP 방식이 더 정밀한 식각 공정을 진행할 수 있어 첨단 공정에서 많이 사용되고 있습니다.

'반도체공부 > 반도체 공통요소기술' 카테고리의 다른 글
| 반도체 공통요소기술의 이해_플라즈마 장비 주변부 - Scrubber, Pump (0) | 2023.07.16 |
|---|---|
| 반도체 공통요소기술의 이해_플라즈마 장비 주요부 MFC, Vaporizer (0) | 2023.07.15 |
| 반도체 공통요소기술의 이해_반도체 플라즈마 장비 및 진공 부품 이해 (0) | 2023.07.14 |
| 반도체 공통요소기술의 이해_반도체 장비 구성요소 및 공정별 장비 (0) | 2023.07.11 |



